陶瓷封装外壳系列
陶瓷封装外壳系列:产品概览
Section titled “陶瓷封装外壳系列:产品概览” | 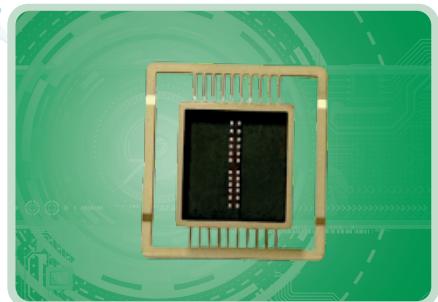 |  |
|---|---|---|
 | 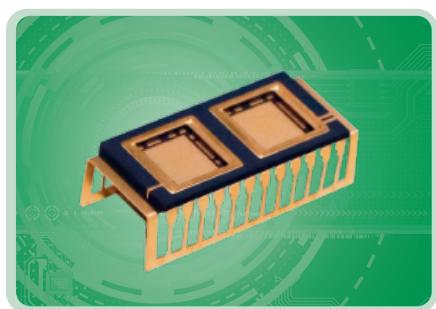 |  |
陶瓷封装外壳系列:陶瓷封装外壳简介
Section titled “陶瓷封装外壳系列:陶瓷封装外壳简介”HTCC陶瓷外壳是在1650℃~1850℃高温下共烧成型,用于高端电子封装的气密性陶瓷封装结构。该陶瓷外壳主要用于保护和支撑内部的电子芯片或元器件,同时提供电气连接、散热和机械保护等功能。
- 产品特性:高布线密度、高绝缘性、高导热性、良好的热匹配性、优异的气密性。
- 应用领域:高端、高可靠性电子封装领域,尤其适用于功率器件、射频模块、光电器件、传感器及医疗电子等对环境耐受性和可靠性要求极高的应用场景。
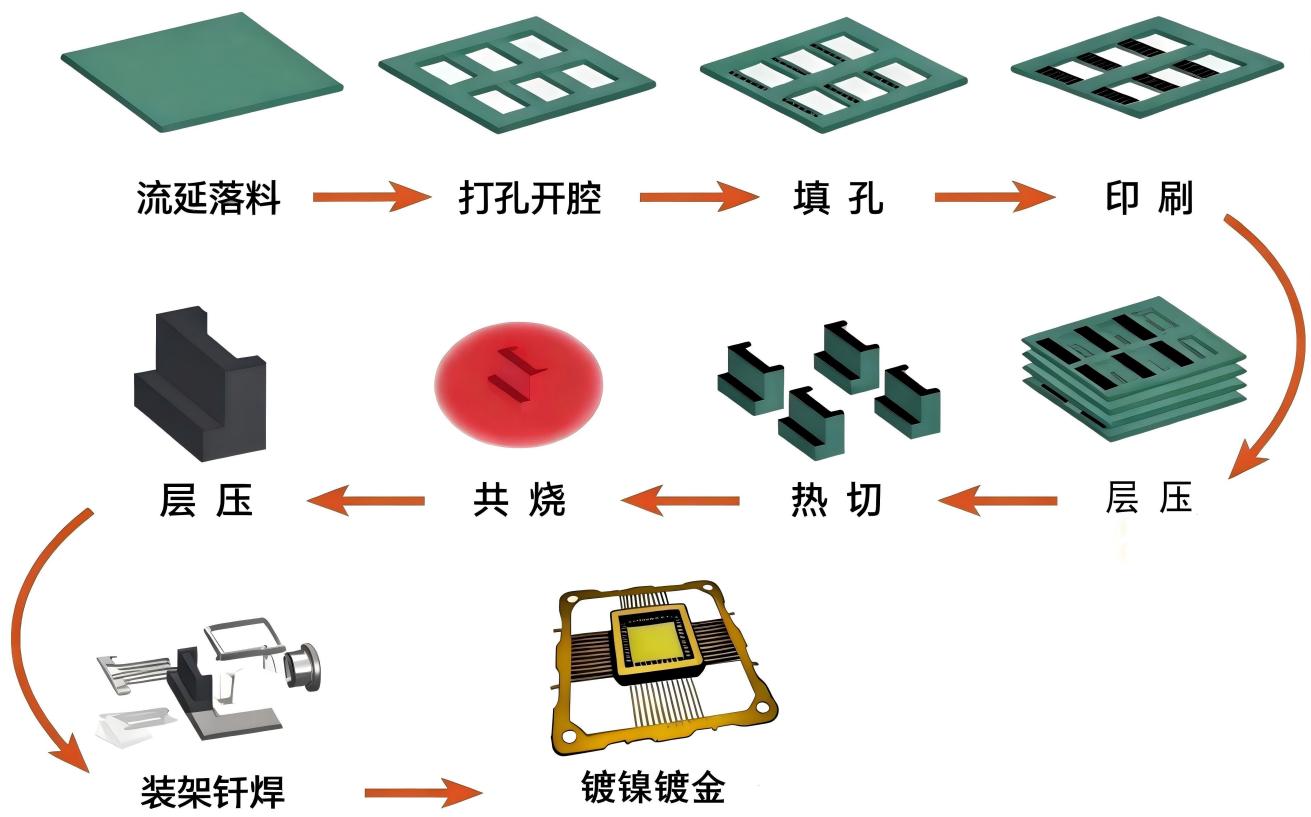
陶瓷封装外壳系列:HTCC外壳材料特性
Section titled “陶瓷封装外壳系列:HTCC外壳材料特性”1. 陶瓷封装外壳系列:陶瓷材料特性
Section titled “1. 陶瓷封装外壳系列:陶瓷材料特性”单位:mm
| 项目 | 频率/条件 | 单位 | 90%氧化铝 | 95%氧化铝 |
|---|---|---|---|---|
| 介电常数 | 10GHz | - | 8.79 | 8.65 |
| 介电常数 | 20GHz | - | 8.79 | 8.65 |
| 介电常数 | 30GHz | - | 8.79 | 8.65 |
| 介电常数 | 40GHz | - | 8.79 | 8.65 |
| 线性膨胀系数 | 25~400°C | ppm/°C | 6.8 | 6.8 |
| 线性膨胀系数 | 25~800°C | ppm/°C | 7.7 | 7.7 |
| 密度 | - | g/cm3 | 3.71 | 3.65 |
| 热导率 | - | W/m.k | 21 | 21 |
| 绝缘电阻(500VDC) | - | /mm | ≥1*10^14 | ≥1*10^14 |
| 表层耐电压 | - | V/mm | >1000 | >1000 |
| 表面性状 | - | - | 哑光黑色 | 哑光白色 |
| 抗弯强度 | - | MPa | ≥400 | ≥400 |
| 耐热性 | - | °C | 1500 | 1500 |
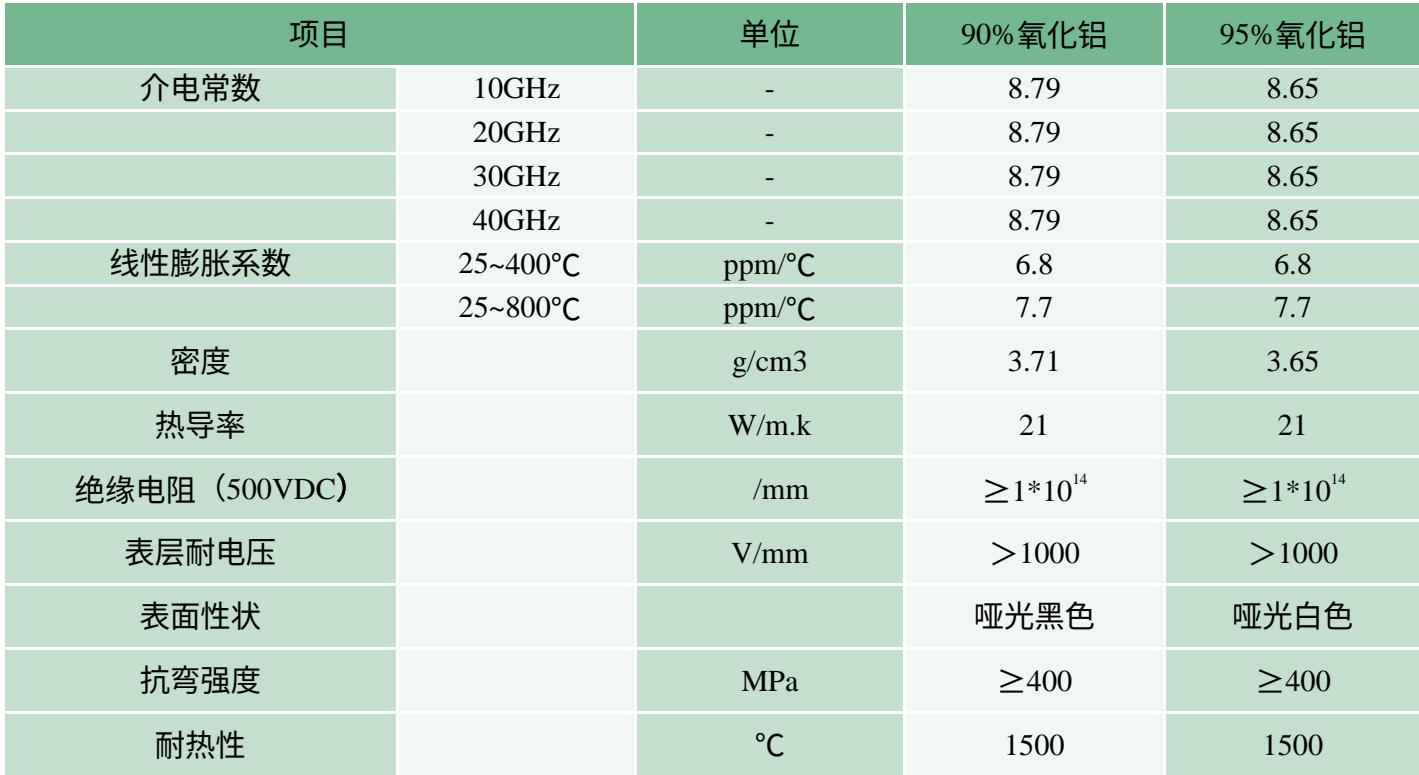 |
2. 陶瓷封装外壳系列:导体材料
Section titled “2. 陶瓷封装外壳系列:导体材料”- 导体材质:陶瓷表面、内部和通孔均为钨导体。
- 表面处理:外露的钨导体表面进行镀镍和镀金处理,以保证后期组装中可焊和键合等要求。
陶瓷封装外壳系列:集成电路陶瓷封装外壳
Section titled “陶瓷封装外壳系列:集成电路陶瓷封装外壳”1. 陶瓷封装外壳系列:CDIP 陶瓷双列外壳
Section titled “1. 陶瓷封装外壳系列:CDIP 陶瓷双列外壳”CDIP即陶瓷双列直插式封装,引脚呈双列对称分布,适配不同功能复杂度的芯片。
- 引脚数量:常规规格4~40个,特殊定制可达64个。
- 金属化最小线径:0.10mm。
- 标准引线截距:2.54mm。
- 结构特点:有单腔、双腔、四腔、多腔等多种腔体结构。
- 应用领域:电耦合器件、数字逻辑芯片、小型光电模块等集成电路封装,适用于低频信号传输。
 |  |  |
|---|---|---|
 |  |  |
2. 陶瓷封装外壳系列:CFP陶瓷扁平外壳
Section titled “2. 陶瓷封装外壳系列:CFP陶瓷扁平外壳”CFP即陶瓷扁平封装,引线采用穿墙互连方式,金属引线水平折弯至底面引出呈现鸥翼形。
- 引脚数量:常规规格6~48个,特殊定制可达64个。
- 金属化最小线径:0.08mm。
- 标准引线截距:1.27mm。
- 窄截距规格:0.50mm、0.65mm、0.80mm,部分特殊型号支持0.40mm。
- 工艺特点:可改为带有散热底板的结构,多采用金锡封口工艺。
- 应用领域:5G通信、医疗精密仪器、电子设备。
 |  | 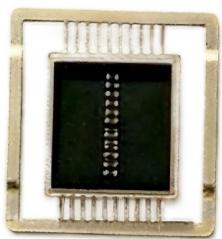 | 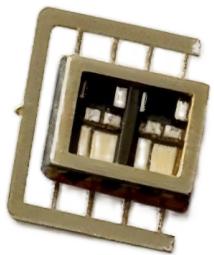 |
|---|---|---|---|
 |  |  |  |
 |  |  |  |
3. 陶瓷封装外壳系列:CSOP 陶瓷小外形外壳
Section titled “3. 陶瓷封装外壳系列:CSOP 陶瓷小外形外壳”CSOP即陶瓷小外形封装,是主流的微型表面贴装封装,采用鸥翼型引脚设计以减少热膨胀应力。
- 引脚数量:常规规格4~36个,特殊定制可达48个。
- 金属化最小线径:0.10mm。
- 标准引线截距:1.27mm。
- 窄截距规格:0.635mm、0.65mm、0.80mm、0.95mm。
- 工艺特点:多采用平行封焊工艺,引脚焊接便利性强,适配大批量生产。
- 应用领域:常规集成电路及对稳定性要求较高的专用芯片。

4. 陶瓷封装外壳系列:CLCC无引线片式载体
Section titled “4. 陶瓷封装外壳系列:CLCC无引线片式载体”CLCC即陶瓷无引线片式载体,引脚以丁字形或金属焊盘形式分布于封装两边或四边。
- 引脚数量:常规规格4~32个,特殊定制可达84个。
- 金属化最小线径:0.10mm。
- 标准引线截距:1.27mm。
- 窄截距规格:1.00mm、0.65mm。
- 产品优势:寄生参数小、绝缘性好、介质耐压高、体积小、多路并行集成。
- 应用领域:传感器、车载摄像头模组、光电耦合器、工业机器视觉系统。
 |  |  |
|---|---|---|
 |  |  |
5. 陶瓷封装外壳系列:SMD表面贴装器件外壳
Section titled “5. 陶瓷封装外壳系列:SMD表面贴装器件外壳”SMD即陶瓷表面贴装器件,具有体积小、重量轻、电极载流能力强、底板散热性能良好等特点。
- 产品优势:高气密性、优散热性、强电磁兼容性,适合表面贴装工艺。
- 应用领域:大功率二极管、三极管、石英晶体振荡器、MEMS器件、大电流低压差电压调整器。
 |  |  |  |
|---|---|---|---|
 | 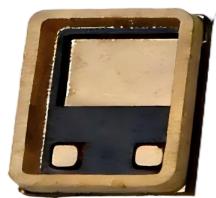 | 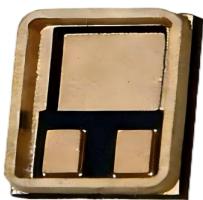 |  |
6. 陶瓷封装外壳系列:CQFN陶瓷四边无引线扁平外壳
Section titled “6. 陶瓷封装外壳系列:CQFN陶瓷四边无引线扁平外壳”CQFN即陶瓷四边扁平无引线封装,以垂直信号传输结构为核心优势。
- 引脚数量:常规规格12~32个,特殊定制可达64个。
- 金属化最小线径:0.10mm。
- 金属化通孔尺寸:0.25mm。
- 标准引线截距:0.50mm。
- 窄截距规格:1.00mm、0.65mm、1.27mm、1.50mm。
- 工艺特点:采用金锡熔封或平行封焊,可搭配金属热沉接地强化散热。
- 应用领域:5G基站微波器件、光电产品、车规级传感器及MEMS器件。
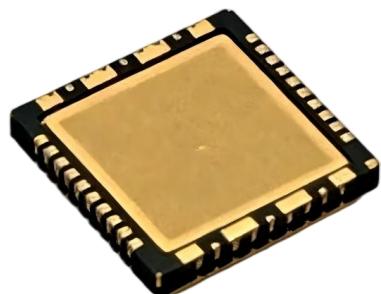 |  |
|---|---|
 |  |
7. 陶瓷封装外壳系列:CQFP陶瓷四边扁平外壳
Section titled “7. 陶瓷封装外壳系列:CQFP陶瓷四边扁平外壳”CQFP即陶瓷四边扁平封装,引脚呈海鸥翼状适配表面贴装。
- 引脚数量:常规规格24~64个,特殊定制可达144个。
- 金属化最小线径:0.10mm。
- 标准引线截距:0.50mm。
- 窄截距规格:0.50mm、0.65mm、0.80mm、1.27mm、1.50mm。
- 工艺特点:部分型号可搭配热沉强化散热,通过金锡熔封工艺保障密封性。
- 应用领域:ECL发射极耦合逻辑电路、CMOS内阵列电路、微控制器、数字模拟转换器、新能源汽车高压大功率电路。
 | 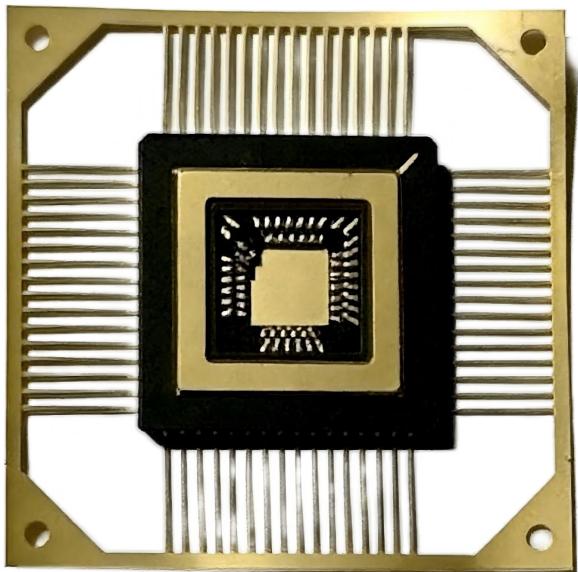 | 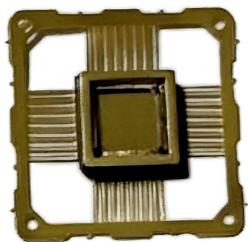 |
|---|
8. 陶瓷封装外壳系列:CPGA/CBGA 陶瓷针栅/球栅阵列外壳
Section titled “8. 陶瓷封装外壳系列:CPGA/CBGA 陶瓷针栅/球栅阵列外壳”- CPGA(陶瓷针栅阵列封装):
- 引脚数量:常规规格28~68个,特殊定制可达94个。
- 规格参数:金属化最小线径0.10mm,标准截距2.54mm,主流窄截距1.27mm。
- 特点:方形或矩形,引脚阵列分布,适配通孔焊接或插座连接,散热与抗干扰能力强。
- CBGA(陶瓷球栅阵列封装):
- 引脚数量:常规规格18~77个,特殊定制可达150个。
- 规格参数:金属化最小线径0.10mm,标准截距0.40mm/0.50mm/0.65mm/0.80mm,主流窄截距0.10mm。
- 特点:引脚阵列分布,适配倒装芯片安装,寄生参数小,散热性强,用于高端CPU等高密度、高性能器件。
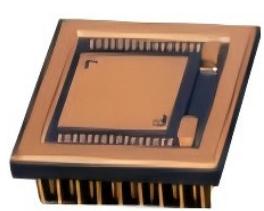 |  |  |  |
|---|---|---|---|
 |  |  |  |
陶瓷封装外壳系列:光电传感器件陶瓷封装外壳
Section titled “陶瓷封装外壳系列:光电传感器件陶瓷封装外壳”1. 陶瓷封装外壳系列:制冷型红外探测器用陶瓷外壳
Section titled “1. 陶瓷封装外壳系列:制冷型红外探测器用陶瓷外壳”- 结构特点:主体采用圆形通腔结构,陶瓷圆环实现电气连接及芯片支撑,金属圆环实现与光窗和外部制冷器的焊接。
- 应用价值:是红外焦平面探测器组件中实现电气功能、低温高真空长寿命、高可靠工作的关键部件。
- 应用领域:各类高精度高可靠红外成像和安全监测领域。

2. 陶瓷封装外壳系列:非制冷型红外探测器用陶瓷外壳
Section titled “2. 陶瓷封装外壳系列:非制冷型红外探测器用陶瓷外壳”- 结构分类:蝶形结构的金属外壳(BTP)、CLCC(QFN)和PGA类型的陶瓷外壳。
- 产品特点:具有多引出端、高可靠性。
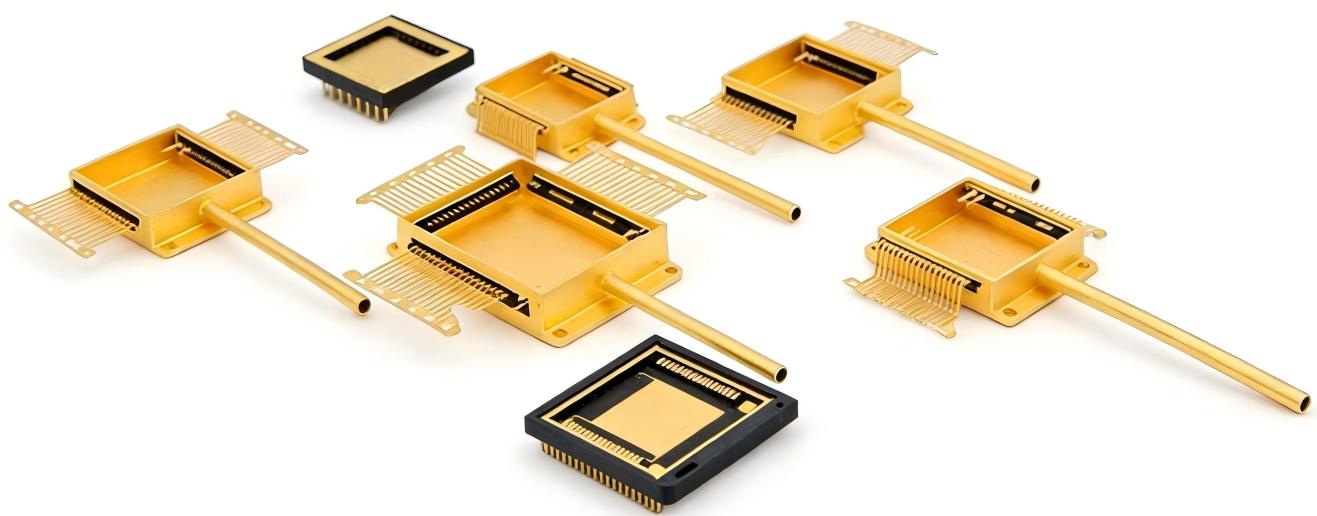
3. 陶瓷封装外壳系列:光通讯陶瓷外壳
Section titled “3. 陶瓷封装外壳系列:光通讯陶瓷外壳”- 应用领域:光纤通信领域,用于封装各类光电发射、接收器件、光开关、大功率激光器。
- 产品系列:14 PIN蝶形外壳、Mini-Dil结构外壳、TOSA/ROSA外壳、大功率激光器外壳系列。
- 定制能力:可安装蓝宝石光窗和50欧姆特性阻抗传输接头,外形、结构和尺寸可定制。
 |  |  |
|---|---|---|
| 蝶形外壳 | Mini-Dil外壳 | TOSA/ROSA外壳 |
陶瓷封装外壳系列:陶瓷基片
Section titled “陶瓷封装外壳系列:陶瓷基片”1. 陶瓷封装外壳系列:陶瓷基片
Section titled “1. 陶瓷封装外壳系列:陶瓷基片”- 产品分类:常规外形基板、异型基板。
- 电镀方式:镍金、镍钯金等。
- 核心优势:高密度互连、高导热、高可靠性。
- 应用领域:5G基站功放、光通信模块、雷达T/R组件、卫星导航设备、医疗超声换能器、工业传感器。
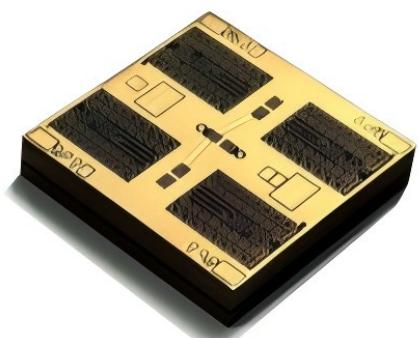 |  |
|---|---|
 |  |